
Samsung робить стратегічну ставку на одну з ключових технологій майбутнього напівпровідникової галузі. Корейський гігант готується до запуску виробництва з використанням hybrid bonding – передового методу пакування чипів, який уже називають революцією для штучного інтелекту. Компанія планує застосувати цю технологію спочатку в NAND-пам’яті, а згодом – у HBM та контрактному виробництві, напряму вступаючи в конкуренцію з TSMC.
Що таке hybrid bonding і чому це важливо
Hybrid bonding – це технологія вертикального з’єднання напівпровідникових кристалів без використання традиційних паяних контактів або мікробампів. Замість цього чипи з’єднуються безпосередньо через поєднання оксидного шару (SiO₂) та міді (Cu).
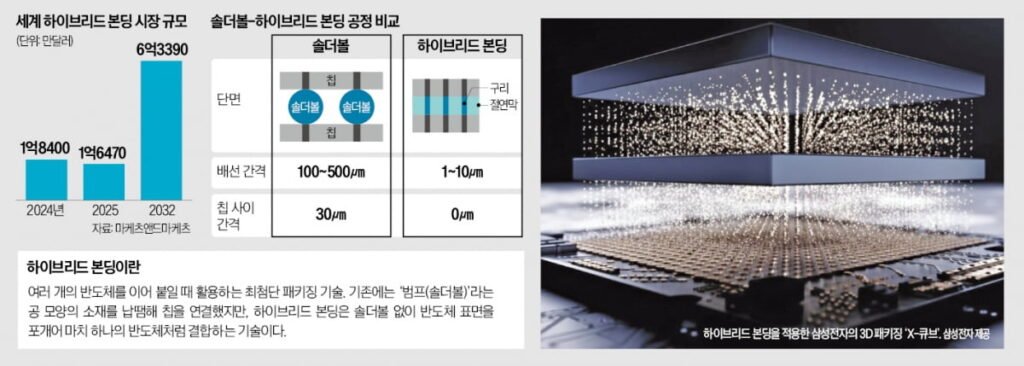
Такий підхід забезпечує одразу кілька критично важливих переваг: швидкість передачі даних зростає більш ніж у 15 разів, енергоефективність покращується щонайменше утричі, щільність з’єднань збільшується до 200 разів, а загальна товщина чипів зменшується, що робить hybrid bonding ключовою технологією для ШІ-прискорювачів, серверних процесорів і пам’яті нового покоління.
TSMC: перший хід уже зроблено

Хоча Samsung лише готується до масштабного запуску, TSMC має фору в цій технології. Тайванська компанія ще у 2022 році представила власну реалізацію hybrid bonding під брендом SoIC.
Саме TSMC першою впровадила цю технологію у серійних продуктах – зокрема в процесорах AMD EPYC із 3D V-Cache, де обчислювальні кристали та SRAM були з’єднані вертикально. За даними компаній, це дало кратне зростання щільності з’єднань і суттєве покращення енергоефективності.
Після цього до SoIC почали придивлятися й інші великі замовники, включно з NVIDIA, яка застосовує hybrid bonding у нових архітектурах для дата-центрів і ШІ.









